毫米波需求催生AiP,FO-WLP市场仍具前景
在移动通讯技术长久的发展历史上,毫米波因为其穿透性差以及信号衰减快等缺点一直不受待见。但随着人们对于信息传输速度的需求日益增长,在技术的进步下,毫米波其可靠性高、方向性强、延迟低、传输速率高等特点也被5G技术所利用。
另一方面,5G毫米波需求下,SiP封装设计同时也存在着许多挑战。日月光集团研发中心产品设计处处长王陈肇博士认为,目前毫米波SiP封装设计存在着六大挑战,包括有宽带高增益天线封装的设计、铜密度、低损耗互联与基板材料、制造过程高精度控制、散热以及低成本的基板与装配方案。首先,与2G/3G/4G移动网络相比,5G网络将在更高频段的C-Band(3.7-4.2GHz)和毫米波(24.25GHz-52.6GHz)上部署,而更高频率的信号就意味着更大的馈线损耗,传统4G手机射频前端的馈线损耗只有1dB不到,但是在毫米波频段线损在2-4dB。这也是在毫米波的应用中习惯将天线与射频前端等器件集成的原因,系统级封装技术能够使天线与各类射频元件在垂直层面上堆叠,大大缩短连接距离,也就减少了信号传输损耗。而为了与SiP封装区分开,将天线封装到射频模块中的技术也被称为天线封装(Antenna inPackage,AiP)。

更多的元件被整合到单一封装模块中,必然会造成更大的散热、材料、成本等问题。针对AiP封装,王陈肇博士表示,为了解决高频信号传输损耗、降低成本和进一步减少厚度,目前一般在毫米波应用中使用的技术是扇出型晶圆级封装(FO-WLP)工艺。WLP晶圆级封装是以球栅阵列(BGA)技术为基础,直接对晶圆进行加工,在一块晶圆上同时对多个芯片进行封装测试,切割后即可直接贴装到基板上的一种封装方法。而WLP由于不需要中介层,不需要使用基板材料,并省略了打线等步骤,因此可以大幅降低成本。另一方面,FO-WLP最终在成品中是不存在封装基板的,因为其封装方式是从裸晶端点直接将电路拉线到重布线层(RDL),这可以降低成本,并使得封装厚度能够大大降低,提升I/O密度。同时,RDL层可以缩短电路互联的距离长度,这对于高频信号传输损耗的降低起到关键作用。
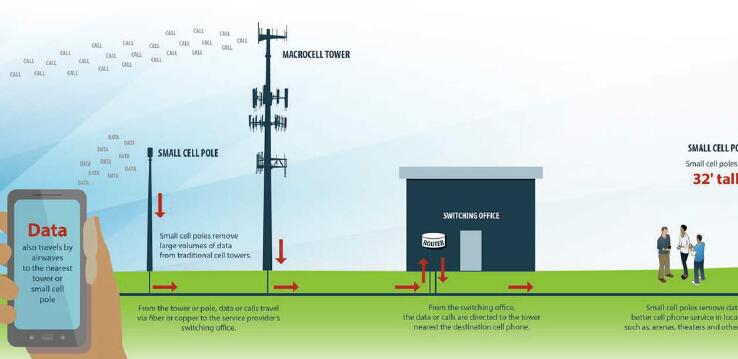
事实上,扇出型封装工艺早在2009年,英特尔就首先在手机基带芯片上使用到FO-WLP工艺,不过当时该技术并未能大规模普及。而这项技术的最大推动者,还是苹果。2016年苹果首次在iPhone7的A10处理器上采用了FO-WLP工艺,在此之后,设备商Veeco,封装测试供应商星科金朋、Amkor、日月光,晶圆代工厂Global Foundries等都加大了FO-WLP的产品、技术布局。
根据市场研究机构Yole Developpement的数据显示,2016-2017全球FO-WLP市场复合年增长率将近90%,2018达到了14亿美元的规模。据预测,随着5G的推进,全球FO-WLP市场规模有望在2022年超过23亿美元,2019-2022年间的复合年增长率将接近20%。
尽管,目前在国内的5G建设仍以sub-6频段为主,不过从目前公布的消息来看,中国移动已完成了5G毫米波关键技术验证,将计划在2020年实现5G毫米波商用部署。于此同时,在2019深圳国际电子展上,某国内天线模组厂商的技术人员也告诉记者,他们也已经有毫米波天线模组产品的样品,将会在2020年中正式将产品推出市场。因此,毫米波的需求大门在2020年正式打开,AiP与FO-WLP市场将会迎来新一轮增长。
下一篇:供应紧张 被动元件涨潮不断
分类资讯
热点排行
- 1两项指标均高于我们业务展望的中位数。
- 2用二氧化硅(SiO2)来消除边缘区域的电场
- 3该模块集成了几个基本组件
- 4新能源汽车产业的革新,离不开数字化、双碳两大时代底色
- 5应届毕业生大马,此前一直以为自己是足够幸运的那个
- 6从芯片行业的发展背景来看,芯片需离不开终端的发展
- 7全新高性价比工业级Cortex-A55核心板不限量发售
- 8中国电子展将以“创新强基 应用强链”为主题
- 9芯片厂商们披露业绩“创新高”
- 10元器件电子元器件的发展史其实就是一部浓缩的电子发展史






